设备
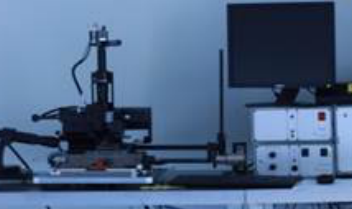 |
仪器名称:亚微米倒装贴片机 Submicron Flip Chip Bonder
型号:Fineplacer Lambda 生产厂家:德国Finetech GmbH & Co. KG |
技术指标及配置:
|
倒装贴片精度 |
+/- 0.5μm |
芯片大小 |
0.15-40 mm |
|
基板尺寸 |
最大190×104 mm |
工作台高度调节 |
0-10 mm |
|
基板加热 |
50×50 mm;RT - 400°C; 升温速率1-20 °C /s |
键合压力 |
0.1-20 N |
|
超声键合 |
功率20 W, 时间4 s, 频率60 KHz |
|
|
主要功能及用途:
带惰性气体保护腔体;配置工艺观察相机,具有工艺观察并摄像能力;配置点胶机,具有点和线的点胶功能;Window软件平台,闭环控制并实时显示键合温度、超声参数等,具有键合工艺追踪能力(log功能),能够适时采集顶视和侧视工艺图像及视频并保存
版权所有©复旦大学智能电子与系统研究院版权所有
地址:淞沪路2005号复旦大学江湾校区交叉学科二号楼7楼 电话:021-31242626


 loading......
loading......